Плоский пакет без потенциальных клиентов - Flat no-leads package

Плоские безлиды пакеты, такие как квадроцикл без проводов (QFN) и двойной плоский без проводов (DFN) физически и электрически соединить интегральные схемы к печатные платы. Плоские выводы без проводов, также известные как микрообразцы с выводами (MLF) и SON (без выводов с мелким контуром), являются технология поверхностного монтажа, одна из нескольких пакетных технологий, которые соединяют ИС к поверхности из Печатные платы без сквозные отверстия. Плоский без вести - это почти шкала чипа пластиковый инкапсулированный пакет с плоским медь Подложка свинцовой рамки. По периметру прилегает к нижней части корпуса и обеспечивает электрические соединения с Печатная плата.[1] Плоские пакеты без свинца включают открытые теплопроводящая прокладка для улучшения теплоотдачи из IC (в печатную плату). Металл может дополнительно облегчить теплопередачу. переходные отверстия в термопрокладке.[2] Пакет QFN похож на четырехквартирный пакет (QFP), а массив сетки мячей (BGA).
Плоское поперечное сечение без выводов
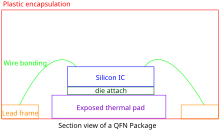
На рисунке показано поперечное сечение плоского корпуса без свинца с свинцовая рамка и проводное соединение. Есть два типа конструкции кузова: удар пунша и видел сингуляцию.[3] Распиловка разрезает на части большой комплект пакетов. При разделении пуансонов единая упаковка формуется в форму. На поперечном срезе показан корпус с пильной вставкой с прикрепленной термоголовкой. Выводная рамка изготовлена из медного сплава, а для крепления кремниевого кристалла к термопрокладке используется теплопроводный клей. Кремниевый кристалл электрически соединен с выводной рамкой на 1–2ты диаметр золотые провода.
Подушечки пильного пакета могут полностью находиться под упаковка, или они могут складываться по краю упаковки.
Различные виды
Распространены два типа пакетов QFN: QFN с воздушной полостью, с воздушной полостью, встроенной в корпус, и пластиковые формованные QFN с минимальным количеством воздуха в упаковке.
Менее дорогие QFN, отлитые из пластмассы, обычно ограничиваются приложениями до ~ 2–3 ГГц. Обычно он состоит всего из двух частей: пластикового компаунда и медной свинцовой рамы и не имеет крышки.
Напротив, QFN с воздушной полостью обычно состоит из трех частей; медная рамка с выводами, литой пластиковый корпус (открытый и не герметичный) и керамическая или пластиковая крышка. Обычно он дороже из-за своей конструкции и может использоваться для микроволновых приложений до 20–25 ГГц.
Пакеты QFN могут иметь один ряд контактов или двойной ряд контактов.
Преимущества
Этот пакет предлагает множество преимуществ, включая пониженную индуктивность выводов, небольшую площадь основания, близкую к масштабу кристалла, тонкий профиль и малый вес. В нем также используются контактные площадки ввода-вывода по периметру для облегчения трассировки печатной платы, а технология открытой медной контактной площадки обеспечивает хорошие тепловые и электрические характеристики. Эти особенности делают QFN идеальным выбором для многих новых приложений, где важны размер, вес, тепловые и электрические характеристики.
Проблемы проектирования, производства и надежности
Усовершенствованные технологии упаковки и миниатюризация компонентов часто могут привести к новым или неожиданным проблемам с дизайном, производством и надежностью. Так было с пакетами QFN, особенно когда дело доходит до принятия новыми электронными устройствами, не являющимися потребителями. OEM-производители.
Дизайн и изготовление
Некоторые ключевые соображения при проектировании QFN - это дизайн площадки и трафарета. Когда дело доходит до конструкции контактной площадки, можно использовать два подхода: паяльная маска определенная (SMD) или непаяльная маска (NSMD). Подход NSMD обычно приводит к более надежным соединениям, поскольку припаять может приклеиваться как к верхней, так и к боковым сторонам медной площадки.[4] Процесс травления меди также обычно требует более жесткого контроля, чем процесс маскирования припоя, что приводит к более прочным соединениям.[5] Это может повлиять на тепловые и электрические характеристики соединений, поэтому может быть полезно проконсультироваться с производителем упаковки для получения оптимальных рабочих параметров. Контактные площадки SMD могут использоваться, чтобы снизить вероятность перемычка припоя однако это может повлиять на общую надежность соединений. Дизайн трафарета - еще один ключевой параметр в процессе проектирования QFN. Правильная конструкция апертуры и толщина трафарета могут помочь создать более однородные соединения (т.е. минимальные пустоты, газовыделение и плавающие детали) с надлежащей толщиной, что приведет к повышению надежности.[6]
Есть также проблемы со стороны производства. Для более крупных компонентов QFN поглощение влаги во время припой может быть проблемой. Если упаковка сильно впитывает влагу, то нагрев во время оплавления может привести к чрезмерному короблению компонентов. Это часто приводит к тому, что углы компонента отрываются от печатная плата, вызывая неправильное формирование суставов. Чтобы снизить риск коробления во время оплавления, уровень чувствительности к влаге рекомендуется 3 или выше.[7]Некоторые другие проблемы, связанные с производством QFN, включают: плавающую деталь из-за чрезмерного количества паяльной пасты под центральной тепловой подушкой, большие пустоты в припое, плохие характеристики повторной обработки и оптимизацию профиля оплавления припоя.[8]
Надежность
Упаковка компонентов часто определяется рынком бытовой электроники, и меньше внимания уделяется отраслям с более высокой надежностью, таким как автомобилестроение и авиация. Поэтому может быть сложно интегрировать семейства пакетов компонентов, такие как QFN, в среду с высокой надежностью. Компоненты QFN, как известно, подвержены усталость припоя проблемы, особенно термомеханическая усталость из-за термоциклирование. Значительно более низкий зазор в корпусах QFN может привести к более высоким термомеханическим деформациям из-за коэффициент температурного расширения (CTE) несоответствие по сравнению с свинцовыми пакетами. Например, в условиях ускоренного термоциклирования от -40 ° C до 125 ° C, различные четырехъядерный плоский пакет (QFP) компоненты могут выдерживать более 10 000 термических циклов, тогда как компоненты QFN имеют тенденцию выходить из строя примерно при 1 000–3 000 циклов.[7]
Исторически испытание надежности в основном проводилось JEDEC,[9][10][11][12] однако это в первую очередь было сосредоточено на межсоединениях кристалла и 1-го уровня. МПК -9071A[13] попытался решить эту проблему, сосредоточив внимание на межсоединениях 2-го уровня (то есть от корпуса к подложке печатной платы). Проблема с этим стандартом заключается в том, что он был больше принят производителями оригинального оборудования, чем производителями компонентов, которые склонны рассматривать его как проблему, связанную с конкретным приложением. В результате было проведено много экспериментальных испытаний и анализ методом конечных элементов в различных вариантах пакета QFN, чтобы охарактеризовать их надежность и усталость припоя поведение.[14][15][16][17][18][19][20]
Серебрени и др.[21] предложена полуаналитическая модель для оценки надежности паяных соединений QFN при термоциклировании. Эта модель генерирует эффективные механические свойства для пакета QFN и рассчитывает напряжение сдвига и напряжение используя модель, предложенную Ченом и Нельсоном.[22] Затем на основе этих значений определяется плотность рассеянной энергии деформации и используется для прогнозирования характерных циклов до отказа с использованием 2-параметрического Кривая Вейбулла.
Сравнение с другими пакетами
Пакет QFN похож на четырехъядерный плоский пакет, но выводы не выходят из сторон упаковки. Следовательно, сложно паять корпус QFN вручную.
Варианты
Разные производители используют разные названия для этого пакета: ML (рамка с микро выводом) или FN (плоский без вывода), кроме того, существуют версии с контактными площадками со всех четырех сторон (четырехсторонняя) и контактными площадками только с двух сторон (двойные), толщина разная. от 0,9 до 1,0 мм для обычных упаковок и 0,4 мм для очень тонких. Сокращения включают:
| Упаковка | Производитель | |
|---|---|---|
| DFN | двойной плоский корпус без проводов | Атмель |
| DQFN | двойной четырехъядерный плоский корпус без проводов | Атмель |
| cDFN | iC-Haus | |
| TDFN | тонкий двойной плоский корпус без проводов | |
| UTDFN | ультратонкий двойной плоский корпус без свинца | |
| XDFN | чрезвычайно тонкий двойной плоский корпус без свинца | |
| QFN | четырехъядерный плоский пакет без проводов | Амкор Технологии |
| QFN-TEP | четырехъядерный плоский пакет без проводов с открытой площадкой | |
| TQFN | тонкий плоский корпус без свинца | |
| ТОО | безвыводная рамка с выводом | National Semiconductor |
| LPCC | бессвинцовый пластиковый держатель для стружки | ASAT Holdings |
| MLF | микро-выводная рамка | Амкор Технологии и Атмель |
| MLPD | корпус с микросхемой двойной | |
| MLPM | корпус микро-выводной рамки micro | |
| MLPQ | корпус с микро-выводом | |
| DRMLF | двухрядный корпус с микросхемой | Амкор Технологии |
| VQFN / WQFN | очень тонкий четверной плоский без вывода | Инструменты Техаса и другие (например, Atmel) |
| UQFN | ультратонкий четырехъядерный плоский без вывода | Инструменты Техаса и Технология микрочипов |

Корпус с микро выводной рамкой (MLP) - это семейство Интегральная схема Пакеты QFN, используемые в поверхностный монтаж электронный схемотехника. Он доступен в 3-х версиях: MLPQ (Q означает четырехъядерный), MLPM (M означает микро) и MLPD (D означает двойной). Эти корпуса обычно имеют открытую площадку для крепления штампа для улучшения тепловых характеристик. Этот пакет похож на пакеты шкалы чипа (CSP) в строительстве. MLPD разработаны, чтобы обеспечить совместимую замену для мелкоконтрастная интегральная схема (SOIC) пакеты.
Микро свинцовая рамка (MLF) является ближайшим CSP Корпус в пластиковом корпусе с медной выводной рамкой. Этот пакет использует площадки по периметру в нижней части пакета для обеспечения электрического контакта с печатная плата. Лопатка для присоединения кристалла находится на дне поверхности корпуса, чтобы обеспечить эффективный тепловой путь при пайке непосредственно к печатной плате. Это также обеспечивает стабильное заземление за счет использования нисходящих соединений или электрического соединения через проводящий материал для крепления кристалла.
Более поздняя модификация конструкции, которая позволяет использовать соединения с более высокой плотностью, - это двухрядная микросхема (DRMLF) пакет. Это пакет MLF с двумя рядами площадок для устройств, требующих до 164 операций ввода-вывода. Типичные приложения включают жесткие диски, контроллеры USB и беспроводную локальную сеть.
Смотрите также
- Чип-носитель Перечень упаковки чипов и видов упаковки
- Четырехместный плоский пакет
Рекомендации
- ^ Требования к дизайну для контуров твердотельных и связанных продуктов, ПУБЛИКАЦИЯ JEDEC 95, РУКОВОДСТВО ПО ДИЗАЙНУ 4.23
- ^ Бонни С. Бейкер, Меньшие пакеты = большие тепловые проблемы, Microchip Technology Inc.
- ^ http://www.freescale.com/files/analog/doc/app_note/AN1902.pdf
- ^ http://www.dfrsolutions.com/hubfs/Resources/services/Manufacturing-and-Reliability-Challenges-With-QFN.pdf?t=1503583170559
- ^ https://www.microsemi.com/document-portal/doc_view/130006-qfn-an
- ^ http://www.dfrsolutions.com/hubfs/Resources/services/Understanding-Criticality-of-Stencil-Aperture-Design-and-Implementation-QFN-Package.pdf
- ^ а б http://www.dfrsolutions.com/hubfs/Resources/services/The-Reliability-Challenges-of-QFN-Packaging.pdf?t=1502980151115
- ^ http://www.aimsolder.com/sites/default/files/overcoming_the_challenges_of_the_qfn_package_rev_2013.pdf, Силиг К. и Пиджен К. «Преодоление проблем пакета QFN», Протоколы SMTAI, октябрь 2011 г.
- ^ JEDEC JESD22-A104D, май 2005 г., Tempurature Cycling
- ^ JEDEC JESD22-A105C, январь 2011 г., Power and Tempurature Cycling
- ^ JEDEC JESD22-A106B, июнь 2004 г., тепловой удар
- ^ JEDEC JESD22B113, март 2006 г., Метод испытания на изгиб циклическим изгибом на уровне платы для определения характеристик надежности межсоединений компонентов для портативных электронных устройств
- ^ IPC IPC-9701A, февраль 2006 г., Методы испытаний производительности и квалификационные требования для припоев для поверхностного монтажа
- ^ Сайед А. и Канг В. «Вопросы сборки и надежности на уровне платы для корпусов типа QFN». Международная конференция SMTA, 2003 г.
- ^ Ян Ти, Т. и др. «Комплексное моделирование надежности паяных соединений на уровне плат и тестирование корпусов QFN и PowerQFN». Надежность микроэлектроники 43 (2003): 1329–1338.
- ^ Вианко, П. и Нейлсен, М. К. «Термомеханическая усталость пластикового четырехплоскостного блока без свинца (PQFN) на 56 входов / выходов». Международная конференция SMTA, 2015.
- ^ Уайльд, Дж. И Жуковски, Э. «Сравнительный анализ надежности μBGA и QFN». 8-е. Int. Конф. по тепловому, механическому и мультифизическому моделированию и экспериментам в микроэлектронике и микросистемах, 2007 IEEE, 2007.
- ^ De Vries, J., et al. «Надежность паяных соединений корпусов HVQFN, подвергнутых термоциклированию». Надежность микроэлектроники 49 (2009): 331-339.
- ^ 17. Li, L. et al. «Надежность на уровне платы и процесс сборки передовых пакетов QFN». Международная конференция SMTA, 2012.
- ^ Birzer, C., et al. «Исследования надежности бессвинцовых корпусов QFN до конца срока службы с помощью стресс-тестов на уровне платы». Конференция по электронным компонентам и технологиям, 2006 г.
- ^ Серебрени, М., Блаттау, Н., Шарон, Г., Хиллман, К., Маккласки, П. «Полуаналитическая модель усталостной долговечности для оценки надежности паяных соединений в корпусах qfn при термоциклировании». SMTA ICSR, 2017. Торонто, Онтарио.
- ^ Чен, В. Т. и К. В. Нельсон. «Термическое напряжение в клеевых соединениях». Журнал исследований и разработок IBM 23.2 (1979): 179-188.
