Фазовая память - Phase-change memory
| Память компьютера типы |
|---|
| Общий |
| Летучий |
| баран |
| Исторический |
|
| Энергонезависимая |
| ПЗУ |
| NVRAM |
| Ранняя стадия NVRAM |
| Магнитный |
| Оптический |
| В развитии |
| Исторический |
|
Фазовая память (также известный как PCM, PCME, PRAM, PCRAM, ОУМ (овоническая единая память) и C-RAM или же CRAM (халькогенид RAM) является разновидностью энергонезависимая память с произвольным доступом. PRAM используют уникальное поведение халькогенидное стекло. В более старом поколении ПКМ тепло, выделяемое при прохождении электрического тока через нагревательный элемент обычно сделан из нитрид титана использовался для быстрого нагрева и закалки стекла, делая его аморфный, или удерживать его в течение некоторого времени в диапазоне температур кристаллизации, тем самым переключая его на кристаллический государственный. PCM также имеет возможность достигать ряда различных промежуточных состояний, тем самым имея возможность удерживать несколько битов в одной ячейке, но трудности программирования ячеек таким образом не позволяют реализовать эти возможности в других технологиях (в первую очередь флэш-память ) с такой же способностью.
Новые технологии PCM имеют два разных направления. Одна группа проводила множество исследований, пытаясь найти жизнеспособные материальные альтернативы Ge.2Sb2Te5 (GST) с переменным успехом. Другая группа разработала использование GeTe – Sb2Te3 сверхрешетка достичь нетепловых фазовых изменений, просто изменив координационное состояние атомов германия с помощью лазерного импульса. Эта новая межфазная память с изменением фаз (IPCM) добилась многих успехов и продолжает оставаться местом активных исследований.[1]
Леон Чуа утверждал, что все двухконтактные устройства энергонезависимой памяти, включая PCM, следует рассматривать мемристоры.[2] Стэн Уильямс из Лаборатория HP также утверждал, что PCM следует рассматривать мемристор.[3] Однако эта терминология подверглась сомнению, и потенциальная применимость мемристор Теория любого физически реализуемого устройства под вопросом.[4][5]
Фон
В 1960-е гг. Стэнфорд Р. Овшински компании Energy Conversion Devices впервые исследовали свойства халькогенидных стекол как потенциальной технологии памяти. В 1969 году Чарльз Си опубликовал диссертацию,[6][7] в Университете штата Айова, который описал и продемонстрировал возможность устройства памяти с фазовым переходом путем интеграции халькогенидной пленки с диод множество. Кинематографическое исследование 1970 года установило, что механизм памяти с фазовым переходом в халькогенидном стекле включает рост кристаллических волокон, индуцированный электрическим полем.[8][9] В сентябрьском выпуске 1970 г. Электроника, Гордон Мур, соучредитель Intel, опубликовал статью о технологии. Однако проблемы с качеством материалов и энергопотреблением не позволили коммерциализировать технологию. Совсем недавно интерес и исследования возобновились, как вспышка и DRAM технологии памяти, как ожидается, столкнутся с трудностями масштабирования, поскольку чип литография сжимается.[10]
Кристаллическое и аморфное состояния халькогенидного стекла резко различаются. удельное электрическое сопротивление значения. Аморфное состояние с высоким сопротивлением представляет собой двоичный 0, в то время как кристаллическое состояние с низким сопротивлением представляет собой 1.[нужна цитата ] Халькогенид - это тот же материал, который используется в перезаписываемых оптических носителях (например, CD-RW и DVD-RW ). В этих случаях управляются оптические свойства материала, а не его удельное электрическое сопротивление, как халькогениды. показатель преломления также меняется в зависимости от состояния материала.
Хотя PRAM еще не достигла стадии коммерциализации потребительских электронных устройств, почти все прототипы устройств используют халькогенид сплав германий, сурьма и теллур (GeSbTe ) называется GST. В стехиометрия или соотношение элементов Ge: Sb: Te составляет 2: 2: 5. Когда GST нагревается до высокой температуры (более 600 ° C), его халькогенидная кристалличность теряется. После охлаждения он замораживается до аморфного стеклообразного состояния. [11] и это электрическое сопротивление в приоритете. Нагревая халькогенид до температуры выше его точка кристаллизации, но ниже температура плавления, он перейдет в кристаллическое состояние с гораздо меньшим сопротивлением. Время завершения этого фазового перехода зависит от температуры. Более холодным частям халькогенида требуется больше времени для кристаллизации, а перегретые части могут быть переплавлены. Обычно используется шкала времени кристаллизации порядка 100 нс.[12] Это больше, чем у обычных устройств энергозависимой памяти, таких как современные DRAM, которые имеют время переключения порядка двух наносекунд. Однако заявка на патент Samsung Electronics в январе 2006 года указывает, что PRAM может достигать времени переключения до пяти наносекунд.
Более недавнее достижение, впервые предложенное Intel и СТ Микроэлектроника позволяет более тщательно контролировать материальное состояние, позволяя преобразовать его в одно из четырех различных состояний; предыдущие аморфные или кристаллические состояния, а также два новых частично кристаллических. Каждое из этих состояний имеет разные электрические свойства, которые можно измерить во время чтения, что позволяет одной ячейке представлять два бита, удваивая плотность памяти.[13]
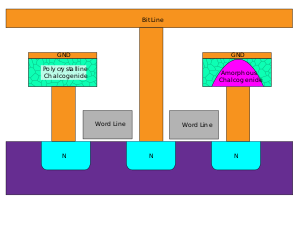
PRAM против Flash
Время переключения PRAM и присущая масштабируемость[14] сделать его наиболее привлекательным. Температурная чувствительность PRAM, пожалуй, является его самым заметным недостатком, который может потребовать изменений в производственном процессе производителей, использующих эту технологию.
Флэш-память работает путем модуляции заряда (электроны ) хранится в воротах МОП-транзистор. Ворота сконструированы со специальной «стопкой», предназначенной для улавливания зарядов (либо на плавающих воротах, либо в изоляторы "ловушки" ). Наличие заряда внутри затвора сдвигает транзистор. пороговое напряжение, выше или ниже, например, от 1 до 0. Изменение состояния бита требует удаления накопленного заряда, что требует относительно большого напряжения, чтобы «отсосать» электроны от плавающего затвора. Этот скачок напряжения обеспечивается зарядный насос, что требует времени для набора мощности. Общее время записи для обычных флэш-устройств составляет порядка 100 мкс (для блока данных), что примерно в 10 000 раз больше типичного времени чтения 10 нс, например, для SRAM (для байта).
PRAM может предложить гораздо более высокую производительность в приложениях, где важна быстрая запись, как потому, что элемент памяти можно переключать быстрее, так и потому, что отдельные биты могут быть изменены на 1 или 0 без необходимости сначала стирать весь блок ячеек. Высокая производительность PRAM, в тысячи раз быстрее, чем у обычных жестких дисков, делает ее особенно интересной в ролях энергонезависимой памяти, производительность которых в настоящее время ограничена временем доступа к памяти.
Кроме того, при использовании Flash каждый скачок напряжения на ячейке вызывает ухудшение характеристик. По мере уменьшения размера ячеек ущерб от программирования увеличивается, поскольку напряжение, необходимое для программирования устройства, не масштабируется литографией. Большинство флеш-устройств в настоящее время рассчитаны только на 5000 операций записи на сектор, а многие флэш-контроллеры выполнять выравнивание износа для распределения записи по множеству физических секторов.
Устройства PRAM также ухудшаются при использовании по другим причинам, чем Flash, но деградируют намного медленнее. Устройство PRAM может выдержать около 100 миллионов циклов записи.[15] Срок службы PRAM ограничен такими механизмами, как деградация из-за теплового расширения GST во время программирования, миграция металла (и других материалов) и другие механизмы, которые пока неизвестны. Помимо ограничения времени жизни, ограниченная стойкость к записи также делает PRAM уязвимым для атак записи, поскольку злоумышленник может многократно записывать в ячейку, чтобы заставить ее выйти из строя.[16] Несколько исследователей предложили методы решения этой проблемы безопасности.[16]
Детали вспышки можно запрограммировать перед пайкой на доска, или даже купленные заранее запрограммированные. Однако содержимое PRAM теряется из-за высоких температур, необходимых для припайки устройства к плате (см. пайка оплавлением или же пайка волной ). Это усугубляется недавней попыткой без свинца производство, требующее более высоких температур пайки. Изготовитель, использующий детали PRAM, должен предоставить механизм для программирования PRAM «в системе» после того, как он будет припаян на место.
Специальные вентили, используемые во флеш-памяти, со временем «пропускают» заряд (электроны), вызывая повреждение и потерю данных. Удельное сопротивление элемента памяти в PRAM более стабильно; при нормальной рабочей температуре 85 ° C предполагается, что данные будут храниться в течение 300 лет.[17]
Тщательно регулируя количество заряда, хранящегося на затворе, флэш-устройства могут хранить несколько (обычно два) бит в каждой физической ячейке. Фактически это удваивает плотность памяти, снижая стоимость. Изначально устройства PRAM сохраняли только один бит в каждой ячейке, но недавние достижения Intel устранили эту проблему.
Поскольку флэш-устройства улавливают электроны для хранения информации, они подвержены повреждению данных из-за излучения, что делает их непригодными для многих космических и военных приложений. PRAM демонстрирует более высокую устойчивость к радиации.
Селекторы ячеек PRAM могут использовать различные устройства: диоды, БЮТ и МОП-транзисторы. Использование диода или BJT обеспечивает наибольшую силу тока для данного размера ячейки. Однако проблема с использованием диода проистекает из паразитных токов в соседних ячейках, а также из-за более высоких требований к напряжению, что приводит к более высокому потреблению энергии. Из-за того, что сопротивление халькогенида обязательно больше, чем у диода, рабочее напряжение должно превышать 1 В с большим запасом, чтобы гарантировать адекватный прямой ток смещения диода. Возможно, наиболее серьезным последствием использования матрицы с диодной селекцией, в частности для больших массивов, является полный ток утечки обратного смещения из невыбранных разрядных линий. В массивах, выбранных транзисторами, только выбранные разрядные линии вносят вклад в ток утечки обратного смещения. Разница в токах утечки составляет несколько порядков. Еще одна проблема при масштабировании ниже 40 нм - это влияние дискретных примесей при уменьшении ширины p-n-перехода. Селекторы на основе тонкой пленки обеспечивают более высокую плотность при использовании <4 F2 область ячейки путем укладки слоев памяти по горизонтали или вертикали. Часто возможности изоляции уступают использованию транзисторов, если соотношение включения / выключения для селектора недостаточно, что ограничивает возможность работы с очень большими массивами в этой архитектуре. Пороговый переключатель на основе халькогенидов был продемонстрирован как жизнеспособный селектор для массивов PCM высокой плотности. [18]
2000 и позже
В августе 2004 года Nanochip лицензировал технологию PRAM для использования в МЭМС (микро-электрические-механические-системы) устройства хранения зондов. Эти устройства не являются твердотельными. Вместо этого очень маленький диск, покрытый халькогенидом, протаскивают под множеством (тысячами или даже миллионами) электрических датчиков, которые могут считывать и записывать халькогенид. Технология микроперемещения Hewlett-Packard может точно позиционировать пластину с точностью до 3 нм, поэтому при усовершенствовании технологии возможна плотность более 1 Тбит (125 ГБ) на квадратный дюйм. Основная идея состоит в том, чтобы уменьшить количество проводов, необходимых на кристалле; Вместо того, чтобы соединять каждую ячейку, ячейки располагаются ближе друг к другу и считываются током, проходящим через датчики MEMS, действующие как провода. Этот подход очень похож на подход IBM. Многоножка технологии.
Ячейка Samsung 46,7 нм
В сентябре 2006 г. Samsung анонсировала прототип устройства на 512 Мб (64 Мб) с диодными переключателями.[19] Объявление стало неожиданностью, особенно примечательно его довольно высокой плотностью. Прототип имел размер ячейки всего 46,7 нм, что меньше, чем у коммерческих Flash-устройств, доступных в то время. Хотя Flash-устройства выше емкость были доступны (64 ГБ или 8 ГБ только что выходили на рынок), другие технологии, конкурирующие за замену Flash, в целом предлагали более низкие плотности (большие размеры ячеек). Единственное производство MRAM и FeRAM устройства всего 4 Мб, например. Высокая плотность прототипа устройства PRAM от Samsung предполагает, что он может быть жизнеспособным конкурентом Flash, и не ограничивается нишевыми ролями, как другие устройства. PRAM оказался особенно привлекательным в качестве потенциальной замены NOR Flash, емкость устройств которого обычно отстает от NAND Флэш-устройства. (Современная емкость NAND превысила 512 Мб некоторое время назад.) NOR Flash предлагает плотность, аналогичную прототипу PRAM от Samsung, и уже предлагает битовую адресацию (в отличие от NAND, где доступ к памяти осуществляется в банках по много байтов за раз).
Устройство Intel PRAM
За заявлением Samsung последовало сообщение от Intel и STMicroelectronics, которые продемонстрировали собственные устройства PRAM на выставке 2006 г. Форум разработчиков Intel в октябре.[20] Они показали деталь размером 128 Мбайт, которую начали производить в исследовательской лаборатории STMicroelectronics в Аграте, Италия. Intel заявила, что устройства были строго экспериментальными.
Устройство BAE
PRAM также является многообещающей технологией в военной и аэрокосмической промышленности, где радиационные эффекты делают использование стандартных энергонезависимых запоминающих устройств, таких как Flash, непрактичным. Устройства памяти PRAM были представлены BAE Systems, называемый C-RAM, заявивший о превосходной радиационной стойкости (круто ) и отстранение иммунитет. Кроме того, BAE утверждает, что продолжительность цикла записи составляет 108, что позволит ему стать претендентом на замену PROM и EEPROM в космических системах.
Многоуровневая ячейка
В феврале 2008 года Intel и STMicroelectronics представили первый многоуровневый (MLC ) Прототип массива PRAM. Прототип хранил два логических бита в каждой физической ячейке, фактически 256 МБ памяти, хранящейся в физическом массиве 128 МБ. Это означает, что вместо двух обычных состояний - полностью аморфного и полностью кристаллического - два дополнительных промежуточных состояния представляют разные степени частичной кристаллизации, что позволяет хранить вдвое больше битов в одной и той же физической области.[13] В июне 2011 г.[21] IBM объявила о создании стабильной, надежной, многобитовой памяти с фазовым переходом, высокой производительности и стабильности. Некоторые инструменты позволяют моделировать площадь / задержку / энергию MLC PCM.[22]
Устройство Intel 90 нм
Также в феврале 2008 года Intel и STMicroelectronics отправили клиентам прототипы своего первого продукта PRAM. Продукт 90 нм, 128 МБ (16 МБ) получил название Alverstone.[23]
В июне 2009 года Samsung и Numonyx B.V. объявили о совместных усилиях по разработке специализированных аппаратных продуктов PRAM.[24]
В апреле 2010 г.[25] Numonyx анонсировала линейку 128-мегабитных NOR-совместимых запоминающих устройств с изменяемой фазой Omneo. Компания Samsung анонсировала поставку 512 МБ оперативной памяти с фазовым переходом (PRAM) в многокристальном корпусе (MCP) для использования в мобильных телефонах к осени 2010 года.
Алюминий / сурьма
Устройства с фазовой памятью на основе германия, сурьмы и теллура представляют собой производственные проблемы, поскольку травление и полировка материала халькогенами может изменить состав материала. Материалы на основе Al и Sb термически более стабильны, чем Ge-Sb-Te. Al50Sb50 имеет три различных уровня сопротивления, предлагая возможность хранить три бита данных в двух ячейках вместо двух (девять состояний, возможных для пары ячеек, использование восьми из этих состояний дает логарифм2 8 = 3 бита).[26][27]
Вызовы
Самой большой проблемой для памяти с фазовым переходом было требование высокой плотности тока программирования (> 107 А / см², по сравнению с 105...106 А / см² для типичного транзистора или диода).[нужна цитата ]Контакт между областью горячего фазового перехода и прилегающим диэлектриком - еще одна фундаментальная проблема. Диэлектрик может начать пропускать ток при более высокой температуре или может потерять адгезию при расширении со скоростью, отличной от скорости материала с фазовым переходом.
Память с измененной фазой имеет высокую задержку записи и высокую энергию, что создает проблемы при ее использовании, хотя в последнее время было предложено множество методов для решения этой проблемы.[28][29]
Память с фазовым переходом подвержена фундаментальному компромиссу: непреднамеренное и преднамеренное изменение фазы. Это связано, прежде всего, с тем фактом, что фазовый переход - это процесс, обусловленный тепловыми воздействиями, а не электронным. Температурные условия, обеспечивающие быструю кристаллизацию, не должны быть слишком похожи на условия ожидания, например комнатная температура. В противном случае сохранение данных невозможно. При правильной энергии активации для кристаллизации можно иметь быструю кристаллизацию в условиях программирования, в то же время имея очень медленную кристаллизацию при нормальных условиях.
Вероятно, самой большой проблемой для памяти с изменением фазы является ее долговременное сопротивление и дрейф порогового напряжения.[30] Сопротивление аморфного состояния медленно растет по степенному закону (~ t0.1). Это сильно ограничивает возможность многоуровневой работы (более низкое промежуточное состояние может быть перепутано с более высоким промежуточным состоянием в более позднее время), а также может поставить под угрозу стандартную работу с двумя состояниями, если пороговое напряжение превышает расчетное значение.
В апреле 2010 года Нумоникс выпустил Омнео линия параллельного и последовательного интерфейса 128 Мб Замена вспышки NOR Чипы PRAM. Хотя микросхемы флэш-памяти ИЛИ-НЕ, которые они намеревались заменить, работали в диапазоне -40 ... 85 ° C, микросхемы PRAM работали в диапазоне 0 ... 70 ° C, что указывает на меньшее рабочее окно по сравнению с флэш-памятью ИЛИ-НЕ. Вероятно, это связано с использованием высокочувствительных к температуре p – n переходов для обеспечения высоких токов, необходимых для программирования.
График
- Январь 1955 г.: Коломиец и Горунова выявили полупроводниковые свойства халькогенидные очки.[31][32]
- Сентябрь 1966 г.: Стэнфорд Овшински подает первый патент на технологию фазового перехода
- Январь 1969: Чарльз Х. Си опубликовал в Университете штата Айова диссертацию о халькогенидном устройстве памяти с фазовым переходом.
- Июнь 1969 г.: Патент США 3448302 (Shanefield), выданный Овшинскому, утверждает первую надежную работу устройства PRAM.
- Сентябрь 1970 г.: Гордон Мур публикует исследования в Журнал Электроника
- Июнь 1999 г.: Создано совместное предприятие «Овоникс» для коммерциализации технологии PRAM
- Ноябрь 1999: Lockheed Martin работает с Ovonyx над PRAM для космических приложений
- Февраль 2000 г.: Intel инвестирует в Овоникс, лицензирует технологию
- Декабрь 2000 г.: ST Microelectronics лицензирует технологию PRAM от Ovonyx
- Март 2002 г.: Macronix подает заявку на патент на безтранзисторную PRAM
- Июль 2003 г.: Samsung начинает работу над технологией PRAM
- 2003 по 2005 год: Патентные заявки, связанные с PRAM, поданные Toshiba, Hitachi, Macronix, Renesas, Elpida, Sony, Matsushita, Mitsubishi, Infineon и другими.
- Август 2004 г.: Nanochip лицензирует технологию PRAM от Ovonyx для использования в хранилище датчиков MEMS
- Август 2004 г.: Samsung анонсирует успешный 64-мегабитный массив PRAM
- Февраль 2005 г.: Elpida лицензирует технологию PRAM от Ovonyx
- Сентябрь 2005 г.: Samsung объявляет об успешном выпуске 256-мегабитного массива PRAM, рекламирует ток программирования 400 мкА
- Октябрь 2005 г.: Intel увеличивает инвестиции в Овоникс
- Декабрь 2005 г.; Hitachi и Renesas анонсируют 1,5 В PRAM с током программирования 100 мкА
- Декабрь 2005 г.: Samsung лицензирует технологию PRAM у Ovonyx
- Июль 2006 г.: BAE Systems начинает продажу первого коммерческого чипа PRAM
- Сентябрь 2006 г.: Samsung анонсирует устройство PRAM емкостью 512 Мбит
- Октябрь 2006 г.: Intel и STMicroelectronics демонстрируют 128-мегабитный чип PRAM
- Декабрь 2006 г.: IBM Research Labs демонстрирует прототип 3 на 20 нанометров[33]
- Январь 2007 г.: Qimonda лицензирует технологию PRAM от Ovonyx
- Апрель 2007 г.: Главный технический директор Intel Джастин Раттнер собирается провести первую публичную демонстрацию технологии PRAM (ОЗУ с фазовым переходом). [34]
- Октябрь 2007 г.: Hynix начинает преследование PRAM лицензирование технологии Овоникс
- Февраль 2008 г.: Intel и STMicroelectronics анонсируют MLC PRAM с четырьмя состояниями[13] и начать отправку образцов клиентам.[23]
- Декабрь 2008 г.: Numonyx объявляет о выпуске в серийное производство 128-мегабитного устройства PRAM для выбранного покупателя.
- Июнь 2009 г.: Оперативная память Samsung с фазовым переходом поступит в массовое производство, начиная с июня.[35]
- Сентябрь 2009 г.: Samsung объявляет о начале серийного производства устройства PRAM 512 Мбит[36]
- Октябрь 2009 г.: Intel и Numonyx объявляют, что нашли способ объединить массивы памяти с фазовым переходом на одном кристалле.[37]
- Декабрь 2009 г.: Numonyx анонсирует продукт 1 Гб 45 нм[38]
- Апрель 2010 г.: Numonyx выпускает серию Omneo PRAM (P8P и P5Q), обе с длиной волны 90 нм.[39]
- Апрель 2010 г.: Samsung выпускает 512 Мбит PRAM с 65 нм техпроцессом в мультичиповом корпусе.[40]
- Февраль 2011 г.: Samsung представила PRAM 58 нм 1.8V 1Gb.[41]
- Февраль 2012 г.: Samsung представила PRAM 20 нм 1.8V 8Gb[42]
- Июль 2012 г.: Micron объявляет о доступности Phase-Change Memory для мобильных устройств - первого решения PRAM в массовом производстве[43]
- Январь 2014: Micron изымает с рынка все детали PCM.[44]
- Май 2014 г.: IBM демонстрирует объединение PCM, обычной NAND и DRAM на одном контроллере.[45]
- Август 2014 г.: Western Digital демонстрирует прототип хранилища PCM с 3 миллионами операций ввода-вывода и задержкой 1,5 микросекунды.[46]
- Июль 2015 г.: Intel и Micron объявили 3D Xpoint память, в которой сплав с фазовым переходом используется как запоминающая часть ячейки памяти.
Смотрите также
- Сегнетоэлектрическое ОЗУ (КАДР)
- Магниторезистивная память с произвольным доступом (MRAM)
- Основная память для чтения (RMM)
Рекомендации
- ^ Simpson, R.E .; П. Фонс; Колобов А.В. Т. Фукая; и другие. (Июль 2011 г.). «Межфазная память с фазовым переходом». Природа Нанотехнологии. 6 (8): 501–505. Bibcode:2011НатНа ... 6..501С. Дои:10.1038 / nnano.2011.96. PMID 21725305. S2CID 6684244.
- ^ Чуа, Л. О. (2011), "Память с переключением сопротивления - мемристоры", Прикладная физика A, 102 (4): 765–783, Bibcode:2011АпФА.102..765С, Дои:10.1007 / s00339-011-6264-9
- ^ Меллор, Крис (10 октября 2011 г.), «HP и Hynix будут производить мемристорные изделия к 2013 году», Реестр, получено 2012-03-07
- ^ Meuffels, P .; Сони, Р. (2012). «Фундаментальные вопросы и проблемы реализации мемристоров». arXiv:1207.7319 [cond-mat.mes-hall ].
- ^ Ди Вентра, Массимилиано; Першин, Юрий В. (2013). «О физических свойствах мемристивных, мем-емкостных и меминдуктивных систем». Нанотехнологии. 24 (25): 255201. arXiv:1302.7063. Bibcode:2013Нанот..24л5201Д. CiteSeerX 10.1.1.745.8657. Дои:10.1088/0957-4484/24/25/255201. PMID 23708238. S2CID 14892809.
- ^ "Устройства памяти, использующие бистабильное сопротивление в аморфных пленках As-Te-Ge" К. Х. Си, докторская диссертация, Университет штата Айова, публикация Proquest / UMI № 69-20670, январь 1969 г.
- ^ "Халькогенидное стекло с бистабильной памятью удельного сопротивления" C.H. Си, А.В. Похм, П. Уттехт, А. Као и Р. Агравал, IEEE, MAG-6, 592, сентябрь 1970 г.
- ^ "Индуцированное электрическим полем образование нити в полупроводнике As-Te-Ge" C.H. Си, Р. Уттехт, Х. Стивенсон, Дж. Д. Гринер и К. Рагхаван, Журнал некристаллических твердых тел, 2, 358–370, 1970
- ^ «Кинематографическое исследование механизмов памяти с изменением фаз». YouTube. 2012-06-21. Получено 2013-09-17.
- ^ "Является ли флеш-память NAND умирающей технологией?". Techworld. Получено 2010-02-04.
- ^ Каравати, Себастьяно; Бернаскони, Марко; Kühne, Thomas D .; Крак, Матиас; Парринелло, Микеле (2007). «Сосуществование тетраэдрических и октаэдрических узлов в аморфных материалах с фазовым переходом». Письма по прикладной физике. 91 (17): 171906. arXiv:0708.1302. Bibcode:2007ApPhL..91q1906C. Дои:10.1063/1.2801626. S2CID 119628572.
- ^ Х. Хорий и др., Симпозиум по технологии СБИС, 2003 г., 177–178 (2003).
- ^ а б c Прорыв в памяти, Кейт Грин, Обзор технологий, 4 февраля 2008 г.
- ^ Симпсон, Р. Э. (2010). «К конечному пределу изменения фазы в Ge2Sb2Te5». Нано буквы. 10 (2): 414–419. Bibcode:2010NanoL..10..414S. Дои:10.1021 / nl902777z. PMID 20041706. S2CID 9585187.
- ^ «Intel в этом году исследует память с фазовым переходом». Архивировано из оригинал на 2007-03-23. Получено 2007-06-30.
- ^ а б "Обзор методов повышения безопасности энергонезависимых воспоминаний ", Миттал и др., Журнал безопасности оборудования и систем, 2018 г.
- ^ Пировано, А. Редаэлли, А. Пеллизцер, Ф. Оттогалли, Ф. Този, М. Иелмини, Д. Лакайта, А.Л. Без, Р. Исследование надежности энергонезависимой памяти с фазовым переходом. Транзакции IEEE о надежности устройств и материалов. Сентябрь 2004 г., том 4, выпуск 3, стр. 422–427. ISSN 1530-4388.
- ^ И.В. Карпов, Д. Кенке, Д. Кау, С. Танг и Дж. Спадини, MRS Proceedings, том 1250, 2010 г.
- ^ SAMSUNG представляет новое поколение энергонезависимой памяти - PRAM
- ^ Intel анонсирует потенциальную замену Flash
- ^ «IBM разрабатывает« мгновенную »память, в 100 раз быстрее, чем флэш». engadget. 2011-06-30. Получено 2011-06-30.
- ^ "DESTINY: комплексный инструмент с возможностью трехмерного и многоуровневого моделирования памяти клеток ", Миттал и др., JLPEA, 2017 г.
- ^ а б «Intel и STMicroelectronics представили первые в отрасли прототипы памяти с фазовым переходом». Нумоникс. 2008-02-06. Архивировано из оригинал на 2008-06-09. Получено 2008-08-15.
- ^ «Samsung Electronics и Numonyx объединили усилия в области памяти с фазовым переходом». Samsung. 2009-06-23.
- ^ «Samsung будет поставлять MCP с фазовым переходом». EE Times. 2010-04-28. Получено 2010-05-03.
- ^ "Заменит ли память с фазовым переходом флеш-память?". KurzweilAI. Получено 2013-09-17.
- ^ Чжоу, X .; Wu, L .; Песня, З .; Rao, F .; Ren, K .; Peng, C .; Песня, С .; Лю, Б .; Xu, L .; Фэн, С. (2013). «Характеристики фазового перехода материалов с фазовым переходом Al-Sb для применения в памяти с фазовым переходом». Письма по прикладной физике. 103 (7): 072114. Bibcode:2013АпФЛ.103г2114З. Дои:10.1063/1.4818662.
- ^ "Обзор методов управления питанием для памяти с изменением фаз ", С.Миттал, IJCAET, 2015.
- ^ "Обзор архитектурных подходов к управлению встроенной памятью DRAM и энергонезависимыми встроенными кэшами ", Миттал и др., TPDS, 2015.
- ^ И.В. Карпов, М. Митра, Д. Кау, Дж. Спадини, Ю.А. Крюков, В. Карпов, J. Appl. Phys. 102, 124503, 2007 г.
- ^ Коломиец, Б. Т. (1964). «Стекловидные полупроводники (I)». Физика Статус Solidi B. 7 (2): 359–372. Bibcode:1964ПССБР ... 7..359К. Дои:10.1002 / pssb.19640070202.
- ^ Коломиец, Б. Т. (1964). «Стекловидные полупроводники (II)». Физика Статус Solidi B. 7 (3): 713–731. Bibcode:1964ПССБР ... 7..713К. Дои:10.1002 / pssb.19640070302.
- ^ Изменение фазы на замену вспышки? В архиве 2007-09-27 на Wayback Machine
- ^ Techworld.com - Intel готовится к первой публичной демонстрации PRAM
- ^ Чипы Engadget Samsung PRAM идут в серийное производство
- ^ Samsung переводит память с фазовым переходом в производство[постоянная мертвая ссылка ]
- ^ Intel и Numonyx достигли вехи в исследованиях с помощью технологии многоуровневой памяти с перекрестной фазой
- ^ Numonyx представит результаты исследования памяти с фазовым переходом на ведущей отраслевой конференции
- ^ Нумоникс новые устройства PRAM
- ^ Samsung поставляет первый в отрасли MCP с чипом PRAM для мобильных телефонов В архиве 2010-08-21 на Wayback Machine
- ^ 58-нм 1,8 В 1 ГБ PRAM с программной полосой пропускания 6,4 МБ / с
- ^ 20-нм PRAM 1,8 В 8 ГБ с пропускной способностью программы 40 МБ / с В архиве 2012-01-31 в Wayback Machine
- ^ Micron объявляет о доступности памяти с фазовым переходом для мобильных устройств
- ^ Меллор, Крис (14 января 2014 г.). "Micron: Hot DRAM. Нам не нужен никакой steenkin 'PCM". www.theregister.co.uk. Реестр. Получено 14 января 2014.
- ^ http://www.extremetech.com/extreme/182096-ibm-demonstrates-next-gen-phase-change-memory-thats-up-to-275-times-faster-than-your-ssd
- ^ http://www.extremetech.com/extreme/187577-hitachis-new-phase-change-ssd-is-orders-of-magnitude-faster-than-any-nand-flash-drive-on-the-market
внешняя ссылка
- Микрон
- Овоникс, Инк.
- Energy Conversion Devices, Inc.
- Hitachi / Renesas PRAM с низким энергопотреблением
- Хранилище датчиков Hewlett-Packard
- Европейский симпозиум Phase Change and Ovonics
- Пресс-релиз BAE C-RAM Radiation-Hardened NVM
- Паспортный лист BAE C-RAM Radiation-Hardened NVM
- Введение в PCM от Numonyx (видео)

